
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
चिप निर्माण प्रक्रियाको पूर्ण व्याख्या (१/२): वेफरदेखि प्याकेजिङ र परीक्षणसम्म
2024-09-18
प्रत्येक अर्धचालक उत्पादनको निर्माणलाई सयौं प्रक्रियाहरू आवश्यक पर्दछ, र सम्पूर्ण निर्माण प्रक्रियालाई आठ चरणहरूमा विभाजन गरिएको छ:वेफर प्रशोधन - ओक्सीकरण - फोटोलिथोग्राफी - नक्काशी - पातलो फिल्म निक्षेप - अन्तरसम्बन्ध - परीक्षण - प्याकेजिङ.
![]()
चरण १:वेफर प्रशोधन
सबै अर्धचालक प्रक्रियाहरू बालुवाको दानाबाट सुरु हुन्छ! किनभने बालुवामा रहेको सिलिकन वेफर उत्पादन गर्न आवश्यक पर्ने कच्चा पदार्थ हो। वेफर्सहरू सिलिकन (Si) वा ग्यालियम आर्सेनाइड (GaAs) बाट बनेको एकल क्रिस्टल सिलिन्डरबाट काटिएका गोल स्लाइसहरू हुन्। उच्च शुद्धताको सिलिकन सामग्री निकाल्नको लागि ९५% सम्म सिलिकन डाइअक्साइडको मात्रा भएको विशेष सामग्री सिलिका बालुवा चाहिन्छ, जुन वेफर बनाउनको लागि मुख्य कच्चा पदार्थ पनि हो। वेफर प्रशोधन माथिको वेफरहरू बनाउने प्रक्रिया हो।
इन्गट कास्टिङ
पहिले, यसमा कार्बन मोनोअक्साइड र सिलिकन छुट्याउन बालुवालाई तताउन आवश्यक छ, र अल्ट्रा-उच्च शुद्धता इलेक्ट्रोनिक ग्रेड सिलिकन (EG-Si) प्राप्त नभएसम्म प्रक्रिया दोहोर्याइन्छ। उच्च-शुद्धता सिलिकन तरलमा पग्लिन्छ र त्यसपछि एकल क्रिस्टल ठोस रूपमा ठोस हुन्छ, जसलाई "इनगट" भनिन्छ, जुन अर्धचालक निर्माणमा पहिलो चरण हो।
सिलिकन इन्गटहरू (सिलिकन स्तम्भहरू) को निर्माण सटीकता धेरै उच्च छ, न्यानोमिटर स्तरमा पुग्छ, र व्यापक रूपमा प्रयोग गरिएको निर्माण विधि Czochralski विधि हो।
इन्गट काट्ने
अघिल्लो चरण पूरा भएपछि, हीराको आराको साथ इन्गटको दुई छेउहरू काट्न आवश्यक छ र त्यसपछि यसलाई निश्चित मोटाईको पातलो स्लाइसहरूमा काट्नुहोस्। इन्गट स्लाइसको व्यासले वेफरको आकार निर्धारण गर्दछ। ठूला र पातलो वेफरहरूलाई थप प्रयोगयोग्य एकाइहरूमा विभाजन गर्न सकिन्छ, जसले उत्पादन लागत घटाउन मद्दत गर्छ। सिलिकन इन्गट काटिसकेपछि, त्यसपछिका चरणहरूमा प्रशोधन दिशालाई मानकको रूपमा सेट गर्नको लागि स्लाइसहरूमा "फ्ल्याट क्षेत्र" वा "डेन्ट" चिन्हहरू थप्न आवश्यक छ।
वेफर सतह पॉलिश
माथिको काट्ने प्रक्रियाबाट प्राप्त स्लाइसहरूलाई "बेयर वेफर्स" भनिन्छ, अर्थात्, प्रक्रिया नगरिएको "कच्चा वेफर्स" भनिन्छ। बेयर वेफरको सतह असमान छ र सर्किट ढाँचा त्यसमा सीधा छाप्न सकिँदैन। त्यसकारण, पहिले ग्राइन्डिङ र रासायनिक नक्काशी प्रक्रियाहरू मार्फत सतहको दोषहरू हटाउन आवश्यक छ, त्यसपछि चिल्लो सतह बनाउनको लागि पालिस गर्नुहोस्, र त्यसपछि सफा सतहको साथ समाप्त वेफर प्राप्त गर्न सफा गरेर अवशिष्ट प्रदूषकहरू हटाउनुहोस्।
चरण 2: ओक्सीकरण
ओक्सीकरण प्रक्रियाको भूमिका वेफरको सतहमा सुरक्षात्मक फिल्म बनाउनु हो। यसले वेफरलाई रासायनिक अशुद्धताहरूबाट जोगाउँछ, चुहावट प्रवाहलाई सर्किटमा प्रवेश गर्नबाट रोक्छ, आयन इम्प्लान्टेशनको समयमा फैलावटलाई रोक्छ, र नक्काशीको समयमा वेफरलाई चिप्लिनबाट रोक्छ।
अक्सीकरण प्रक्रियाको पहिलो चरण अशुद्धता र प्रदूषकहरू हटाउनु हो। यसलाई जैविक पदार्थ, धातु अशुद्धता हटाउन र अवशिष्ट पानी वाष्पीकरण गर्न चार चरणहरू आवश्यक छ। सफा गरेपछि, वेफरलाई 800 देखि 1200 डिग्री सेल्सियसको उच्च तापक्रमको वातावरणमा राख्न सकिन्छ, र वेफरको सतहमा अक्सिजन वा स्टीमको प्रवाहले सिलिकन डाइअक्साइड (अर्थात "अक्साइड") तह बनाउँछ। अक्सिजन अक्साइड तहको माध्यमबाट फैलिन्छ र सिलिकनसँग प्रतिक्रिया गरेर फरक-फरक मोटाईको अक्साइड तह बनाउँछ, र यसको मोटाई अक्सिडेशन पूरा भएपछि मापन गर्न सकिन्छ।

सुक्खा ओक्सीकरण र भिजेको ओक्सीकरण ओक्सीकरण प्रतिक्रियामा विभिन्न अक्सिडेन्टहरूमा निर्भर गर्दै, थर्मल अक्सीकरण प्रक्रियालाई सुख्खा अक्सीकरण र भिजेको अक्सीकरणमा विभाजन गर्न सकिन्छ। पहिलेको सिलिकन डाइअक्साइड तह उत्पादन गर्न शुद्ध अक्सिजन प्रयोग गर्दछ, जुन ढिलो हुन्छ तर अक्साइड तह पातलो र बाक्लो हुन्छ। पछिल्लोलाई अक्सिजन र अत्यधिक घुलनशील पानी वाष्प दुवै चाहिन्छ, जुन तीव्र वृद्धि दर द्वारा विशेषता हो तर कम घनत्व संग एक अपेक्षाकृत बाक्लो सुरक्षात्मक तह।
अक्सिडेन्टको अतिरिक्त, त्यहाँ अन्य चरहरू छन् जसले सिलिकन डाइअक्साइड तहको मोटाईलाई असर गर्छ। पहिलो, वेफर संरचना, यसको सतह दोष र आन्तरिक डोपिङ एकाग्रताले अक्साइड तह उत्पादनको दरलाई असर गर्नेछ। थप रूपमा, अक्सिडेशन उपकरणहरू द्वारा उत्पन्न उच्च दबाव र तापमान, अक्साइड तह छिटो उत्पन्न हुनेछ। अक्सिडेसन प्रक्रियाको क्रममा, वेफरलाई सुरक्षित गर्न र अक्सीकरण डिग्रीमा भिन्नता कम गर्न इकाईमा वेफरको स्थिति अनुसार डमी पाना प्रयोग गर्न पनि आवश्यक छ।
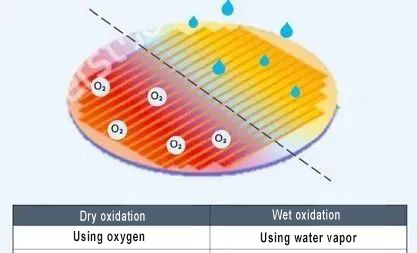
चरण 3: फोटोलिथोग्राफी
फोटोलिथोग्राफी भनेको प्रकाशको माध्यमबाट वेफरमा सर्किट ढाँचालाई "प्रिन्ट" गर्नु हो। हामी यसलाई वेफरको सतहमा अर्धचालक निर्माणको लागि आवश्यक विमान नक्सा कोर्ने रूपमा बुझ्न सक्छौं। सर्किट ढाँचाको उत्कृष्टता जति उच्च हुन्छ, समाप्त चिपको उच्च एकीकरण, जुन उन्नत फोटोलिथोग्राफी प्रविधि मार्फत हासिल गरिनु पर्छ। विशेष गरी, फोटोलिथोग्राफीलाई तीन चरणहरूमा विभाजन गर्न सकिन्छ: कोटिंग फोटोरेसिस्ट, एक्सपोजर र विकास।
कोटिंग
वेफरमा सर्किट कोर्ने पहिलो चरण अक्साइड तहमा फोटोरेसिस्ट कोट गर्नु हो। Photoresist ले यसको रासायनिक गुणहरू परिवर्तन गरेर वेफरलाई "फोटो पेपर" बनाउँछ। वेफरको सतहमा फोटोरेसिस्ट तह जति पातलो हुन्छ, कोटिंग त्यति नै समान हुन्छ, र प्रिन्ट गर्न सकिने ढाँचा त्यति नै राम्रो हुन्छ। यो चरण "स्पिन कोटिंग" विधि द्वारा गर्न सकिन्छ। प्रकाश (अल्ट्राभाइलेट) प्रतिक्रिया को भिन्नता अनुसार, photoresists दुई प्रकार मा विभाजित गर्न सकिन्छ: सकारात्मक र नकारात्मक। अघिल्लो भाग प्रकाशको सम्पर्कमा आएपछि विघटन र गायब हुनेछ, खुला नभएको क्षेत्रको ढाँचा छोडेर, जबकि पछिल्लोले प्रकाशको सम्पर्कमा आएपछि पोलिमराइज हुनेछ र खुला भागको ढाँचा देखा पर्नेछ।
संक्रमण
फोटोरेसिस्ट फिल्म वेफरमा ढाकिएपछि, प्रकाश एक्सपोजर नियन्त्रण गरेर सर्किट प्रिन्टिङ पूरा गर्न सकिन्छ। यो प्रक्रिया "एक्सपोजर" भनिन्छ। हामी एक्सपोजर उपकरण मार्फत प्रकाश पार गर्न सक्छौं। जब प्रकाश सर्किट ढाँचा भएको मास्कबाट जान्छ, सर्किट तल फोटोरेसिस्ट फिल्मको साथ लेपित वेफरमा प्रिन्ट गर्न सकिन्छ।
एक्सपोजर प्रक्रियाको बखत, मुद्रित ढाँचा जति राम्रो हुन्छ, अन्तिम चिपले जति धेरै कम्पोनेन्टहरू समायोजन गर्न सक्छ, जसले उत्पादन दक्षता सुधार गर्न र प्रत्येक कम्पोनेन्टको लागत घटाउन मद्दत गर्छ। यस क्षेत्रमा, नयाँ प्रविधि जुन हाल धेरै ध्यान आकर्षित गरिरहेको छ EUV लिथोग्राफी हो। लाम रिसर्च ग्रुपले रणनीतिक साझेदार ASML र imec सँग मिलेर नयाँ ड्राई फिल्म फोटोरेसिस्ट प्रविधिको विकास गरेको छ। यो टेक्नोलोजीले रिजोलुसनमा सुधार गरेर EUV लिथोग्राफी एक्सपोजर प्रक्रियाको उत्पादकता र उपजलाई धेरै सुधार गर्न सक्छ (फाइन-ट्युनिङ सर्किट चौडाइको मुख्य कारक)।
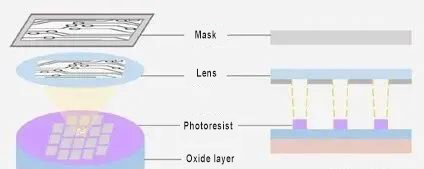
विकास
एक्सपोजर पछिको चरण भनेको विकासकर्तालाई वेफरमा स्प्रे गर्नु हो, यसको उद्देश्य ढाँचाको खुला क्षेत्रमा फोटोरेसिस्ट हटाउनु हो, ताकि मुद्रित सर्किट ढाँचा प्रकट गर्न सकोस्। विकास पूरा भएपछि, सर्किट रेखाचित्रको गुणस्तर सुनिश्चित गर्न विभिन्न मापन उपकरणहरू र अप्टिकल माइक्रोस्कोपहरू द्वारा जाँच गर्न आवश्यक छ।
चरण 4: नक्काशी
सर्किट रेखाचित्रको फोटोलिथोग्राफी वेफरमा पूरा भएपछि, कुनै पनि अतिरिक्त अक्साइड फिल्म हटाउन र अर्धचालक सर्किट रेखाचित्र मात्र छोड्नको लागि नक्काशी प्रक्रिया प्रयोग गरिन्छ। यो गर्नका लागि, तरल, ग्याँस वा प्लाज्मा चयन गरिएको अतिरिक्त भागहरू हटाउन प्रयोग गरिन्छ। त्यहाँ प्रयोग गरिएका पदार्थहरूको आधारमा नक्काशीका दुई मुख्य तरिकाहरू छन्: ओक्साइड फिल्म हटाउन रासायनिक प्रतिक्रिया गर्नको लागि एक विशिष्ट रासायनिक घोल प्रयोग गरेर भिजेको नक्काशी, र ग्यास वा प्लाज्मा प्रयोग गरी ड्राई इचिङ।
भिजेको नक्काशी
ओक्साइड फिल्महरू हटाउन रासायनिक समाधानहरू प्रयोग गरेर भिजेको नक्काशीमा कम लागत, छिटो नक्कन गति र उच्च उत्पादकताका फाइदाहरू छन्। यद्यपि, भिजेको नक्काशी isotropic छ, अर्थात्, यसको गति कुनै पनि दिशामा समान छ। यसले मास्क (वा संवेदनशील फिल्म) लाई पूर्णतया इचेड अक्साइड फिल्मसँग पङ्क्तिबद्ध नगरेको कारणले गर्दा धेरै राम्रो सर्किट रेखाचित्रहरू प्रशोधन गर्न गाह्रो हुन्छ।

सुक्खा नक्काशी
सुक्खा नक्काशीलाई तीन प्रकारमा विभाजन गर्न सकिन्छ। पहिलो रासायनिक नक्काशी हो, जसले नक्काशी ग्यासहरू (मुख्य रूपमा हाइड्रोजन फ्लोराइड) प्रयोग गर्दछ। भिजेको नक्काशी जस्तै, यो विधि आइसोट्रोपिक हो, जसको मतलब यो राम्रो नक्काशीको लागि उपयुक्त छैन।
दोस्रो विधि भौतिक स्पटरिङ हो, जसले अतिरिक्त अक्साइड तहलाई प्रभाव पार्न र हटाउन प्लाज्मामा आयनहरू प्रयोग गर्दछ। एनिसोट्रोपिक नक्काशी विधिको रूपमा, स्पटरिङ एचिङको तेर्सो र ठाडो दिशाहरूमा विभिन्न नक्काशी दरहरू छन्, त्यसैले यसको सूक्ष्मता पनि रासायनिक नक्काशी भन्दा राम्रो छ। यद्यपि, यस विधिको बेफाइदा यो हो कि नक्काशी गति ढिलो छ किनभने यो पूर्ण रूपमा आयन टक्करको कारण हुने शारीरिक प्रतिक्रियामा निर्भर हुन्छ।
अन्तिम तेस्रो विधि प्रतिक्रियात्मक आयन एचिंग (RIE) हो। आरआईईले पहिलो दुई विधिहरू संयोजन गर्दछ, त्यो हो, आयनाइजेसन भौतिक नक्काशीको लागि प्लाज्मा प्रयोग गर्दा, प्लाज्मा सक्रियता पछि उत्पन्न फ्री रेडिकलहरूको मद्दतले रासायनिक नक्कन गरिन्छ। पहिलो दुई विधिहरू भन्दा बढि नक्कली गतिको अतिरिक्त, RIE ले उच्च परिशुद्धता ढाँचा नक्काशी प्राप्त गर्न आयनहरूको एनिसोट्रोपिक विशेषताहरू प्रयोग गर्न सक्छ।
आज, राम्रो सेमीकन्डक्टर सर्किटको उपज सुधार गर्न ड्राई इचिंग व्यापक रूपमा प्रयोग गरिएको छ। फुल-वेफर एचिङ एकरूपता कायम राख्नु र नक्कली गति बढाउनु महत्त्वपूर्ण छ, र आजको सबैभन्दा उन्नत ड्राई इचिङ उपकरणहरूले उच्च प्रदर्शनको साथ सबैभन्दा उन्नत तर्क र मेमोरी चिपहरूको उत्पादनलाई समर्थन गर्दैछ।

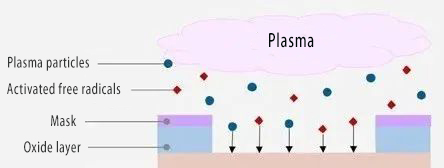
VeTek सेमीकन्डक्टर एक पेशेवर चिनियाँ निर्माता होट्यान्टलम कार्बाइड कोटिंग, सिलिकन कार्बाइड कोटिंग, विशेष ग्रेफाइट, सिलिकन कार्बाइड सिरेमिकरअन्य अर्धचालक सिरेमिक। VeTek Semiconductor अर्धचालक उद्योग को लागी विभिन्न SiC Wafer उत्पादनहरु को लागी उन्नत समाधान प्रदान गर्न प्रतिबद्ध छ।
यदि तपाइँ माथिका उत्पादनहरूमा रुचि राख्नुहुन्छ भने, कृपया हामीलाई सिधै सम्पर्क गर्न नहिचकिचाउनुहोस्।
मोब: +86-180 6922 0752
व्हाट्सएप: +86 180 6922 0752
इमेल: anny@veteksemi.com




